近日,在2025英特尔代工大会上,英特尔展示了多代核心制程和先进封装技术的最新进展,这些突破不仅体现了英特尔在技术开发领域的持续创新,也面向客户需求提供了更高效、更灵活的解决方案。
在制程技术方面,英特尔代工已取得重要里程碑。例如,Intel 18A制程节点已进入风险试产阶段,并计划于今年内实现正式量产。这一节点采用了PowerVia背面供电技术和RibbonFET全环绕栅极晶体管。英特尔代工的生态系统合作伙伴为Intel 18A提供了EDA支持,参考流程和知识产权许可,让客户可以基于该节点开始产品设计。
Intel 18A制程节点的演进版本Intel 18A-P,将为更大范围的代工客户带来更卓越的性能。Intel 18A-P的早期试验晶圆(early wafers)目前已经开始生产。由于Intel 18A-P与Intel 18A的设计规则兼容,IP和EDA合作伙伴已经开始为该演进节点提供相应的支持。Intel 18A-PT是在Intel 18A-P的性能和能效进步基础上推出的另一种Intel 18A演进版本。Intel 18A-PT可通过Foveros Direct 3D先进封装技术与顶层芯片连接,混合键合互连间距小于5微米。
英特尔还在积极开发下一代制程节点Intel 14A,已与主要客户展开合作,发送了Intel 14A PDK(制程工艺设计工具包)的早期版本。这些客户已经表示有意基于该节点制造测试芯片。相对于Intel 18A所采用的PowerVia背面供电技术,Intel 14A将采用PowerDirect直接触点供电技术,进一步优化了功耗和性能。
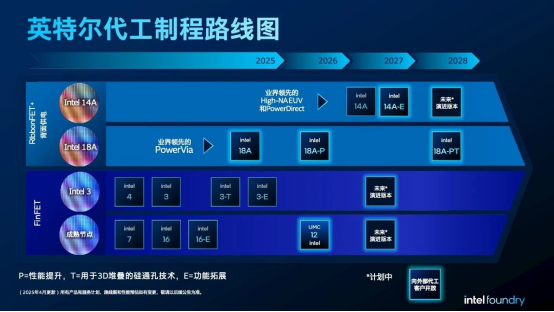
同时,在成熟制程方面,英特尔代工流片的首批基于16纳米制程的产品已经进入晶圆厂生产,也正在与主要客户洽谈与UMC合作开发的12纳米节点及其演进版本。
在先进封装领域,英特尔推出了包括Foveros Direct(3D堆叠)和EMIB(2.5D桥接)在内的多种技术解决方案。英特尔还将向客户提供新的先进封装技术,包括面向未来高带宽内存需求的EMIB-T;在Foveros 3D先进封装技术方面,Foveros-R和Foveros-B也将为客户提供更多高效灵活的选择。
目前,英特尔亚利桑那州的Fab 52工厂已成功完成Intel 18A的流片(run the lot),标志着该厂首批晶圆(wafer)顺利试产成功,展现了英特尔在先进制程制造方面的进展。随着俄勒冈州晶圆厂即将率先实现Intel 18A的大规模量产,英特尔正稳步推进其制程技术的商业化进程。
英特尔凭借其以工程至上为核心的文化,领先的制程技术和先进封装能力,正在不断突破技术边界,为客户提供高性能、低功耗的解决方案。这些技术创新不仅强化了英特尔在半导体行业的竞争力,也为全球科技产业的发展注入了新的动力。未来,英特尔将继续引领技术潮流,为客户和合作伙伴创造更多价值。




